備戰 GAA 架構、連接密度一年內增長 10 倍,Intel 在 IEDM 2022 大會上展示多種新材料的研究與應用
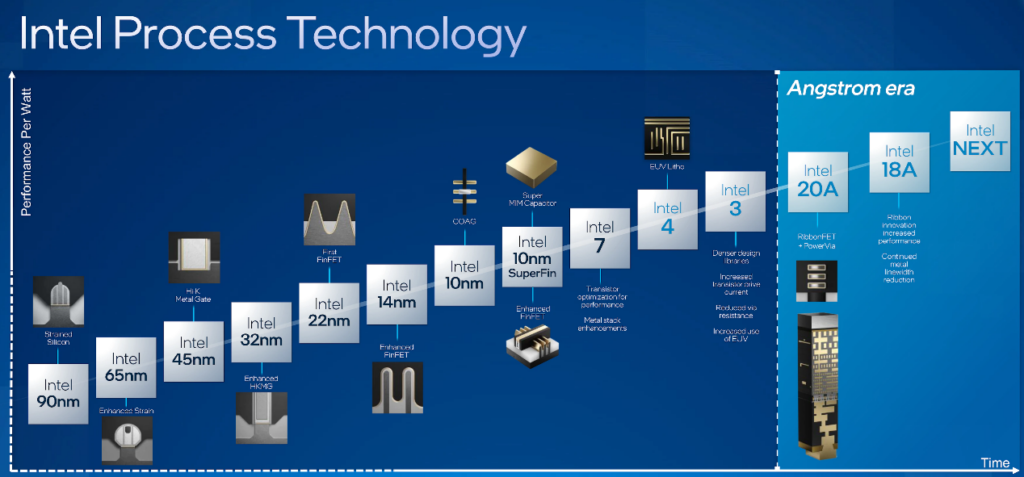
20221205 intelIEDM 01
在今年的 IEDM 2022 IEEE 國際電子設備大會上,Intel 展示了未來處理器的技術路線,確認將在 Intel 20A 製程轉入 GAA 架構,也就是在去年宣布的 RibbonFET 技術,今年官方繼續接露這一年研究成果。
Intel 在未來的晶片設計上將會利用 Chinplet 小晶片技術來實現 3D 晶片堆疊,而為了克服小晶片堆疊時的通道頻寬問題,Intel 使用新的材料來縮減晶片接點的間距和密度,相比去年 2021 年每個接點的間距為 10um,今年成功縮小到了 3um,同時因為間距的縮短,在相同單位面積下的接點數量能夠增加 10 倍,讓電力和訊號的傳輸效率媲美傳統單層晶片設計。


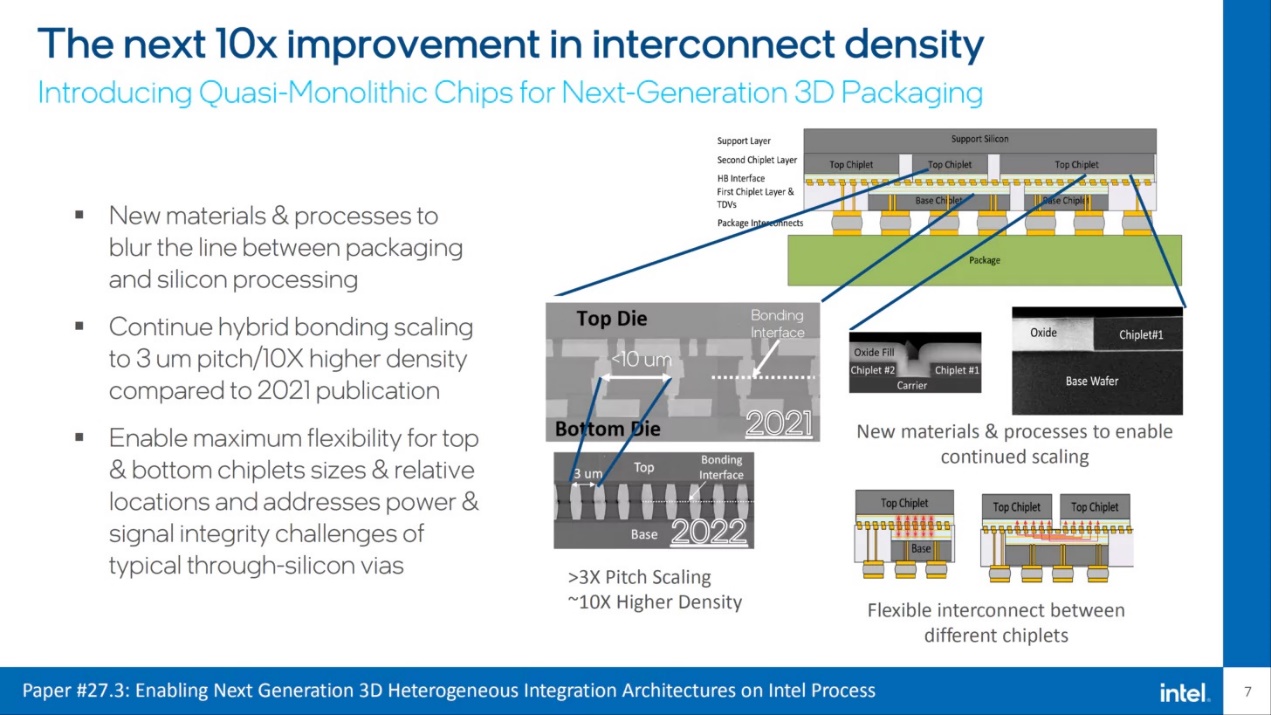
為了 GAA 架構的立體堆疊設計,Intel 開發了全新的通道材料,該材料是一種名為 HfO2 的特製氧化物,本身沒有矽的元素在其中,且厚度僅有 3 個原子高度,Intel 將用它的超薄特性連進行電晶體內部之間的連接。
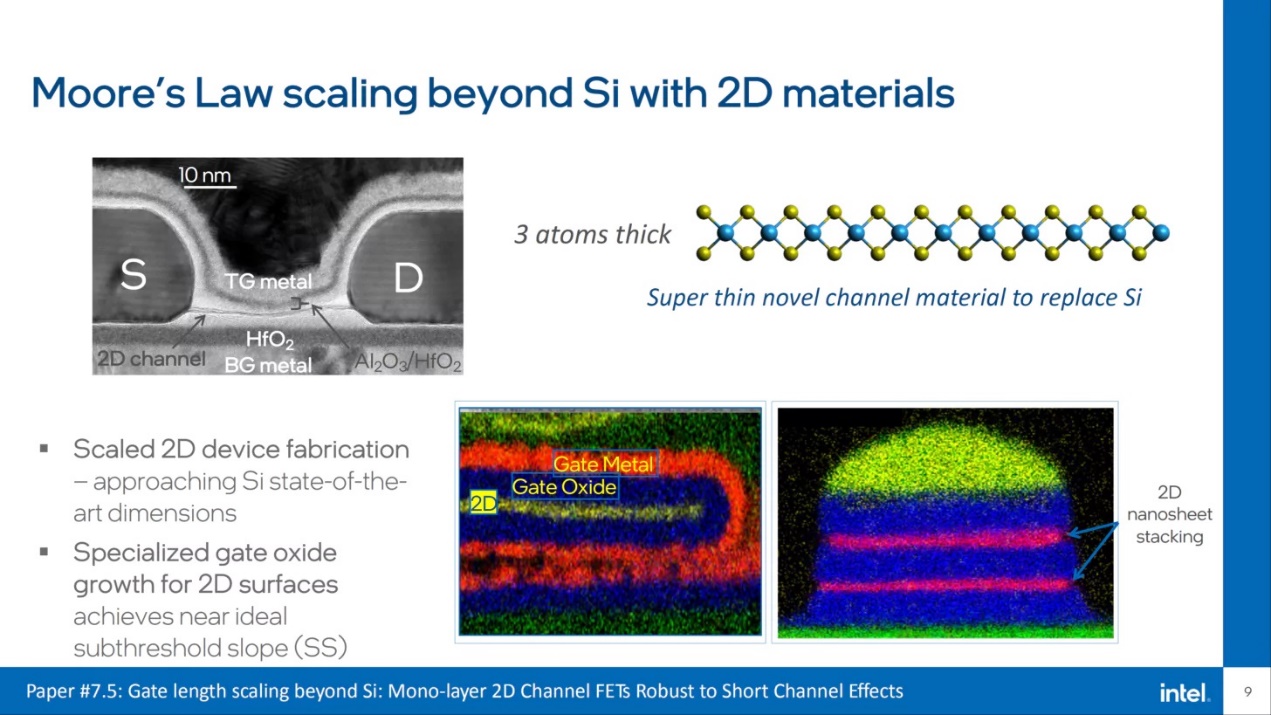
而在外部的部分,Intel 將會使用 MoS2 (二硫化鉬) 來做為下一世代的銜接材料,這個材料有著比矽還要更好的低漏電特性,Intel 將會使用 MoS2 來改善電晶體內部的銜接,以此來增進傳導效率,從而增進效能。

在電晶體之外,Intel 還有還開發了 3D 堆疊的鐵質暫存記憶體 (FeRAM),主要目的是用於晶片內部的記憶體使用,推測應該是讓處理器能夠獲得更大的快取。
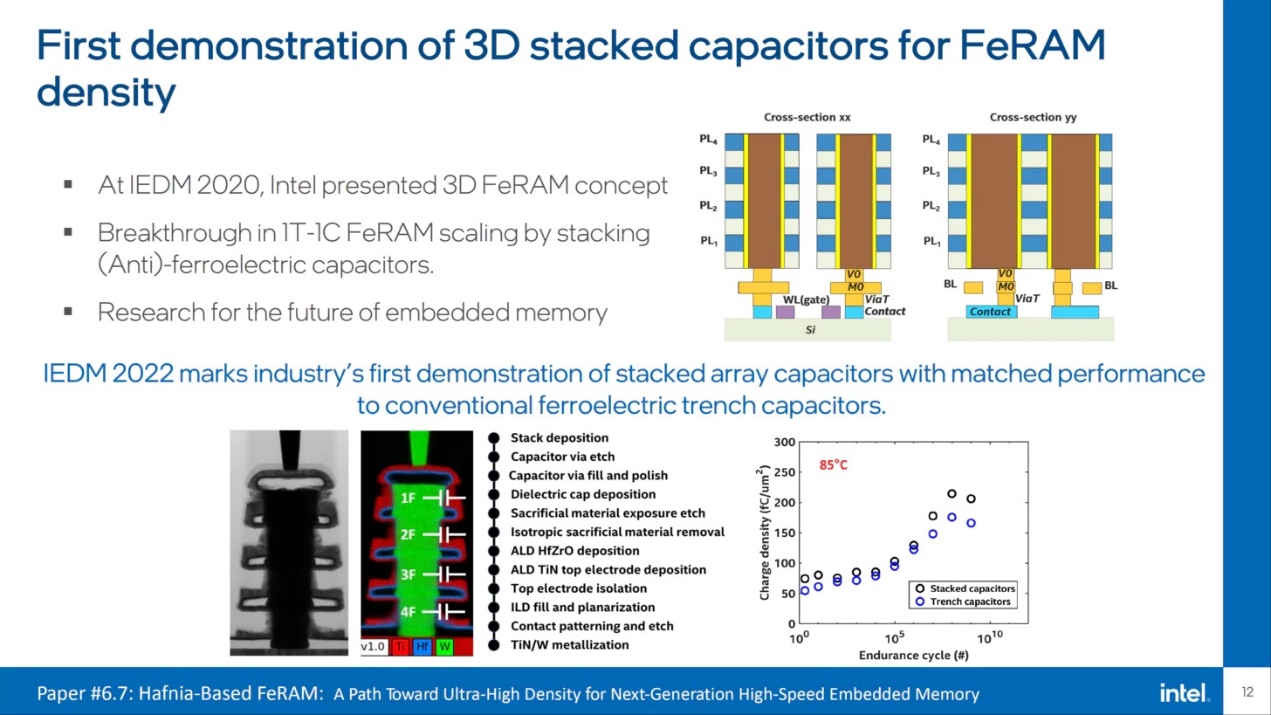
另外,Intel 也踏入氮化鎵 (GaN) 的領域,將發展 300mm 直徑的矽上氮化鎵晶圓,號稱電流傳輸效率能夠比一般的氮化鎵晶片高出 20 倍。

最後,Intel 長期被詬病在功耗放飛自我的問題,本次大會上官方也用新式材料做出回應,發表了一種名為 LBFO (BiFeO3) 的材料,有著能在低電壓環境下迅速切換磁性的特性,僅需 150mv 的電壓就能驅動,並在最快 2 奈秒的時間完成轉換,省電且高速開關的特性,Intel 認為 LBFO 將會是晶片和記憶體的一大關鍵材料。
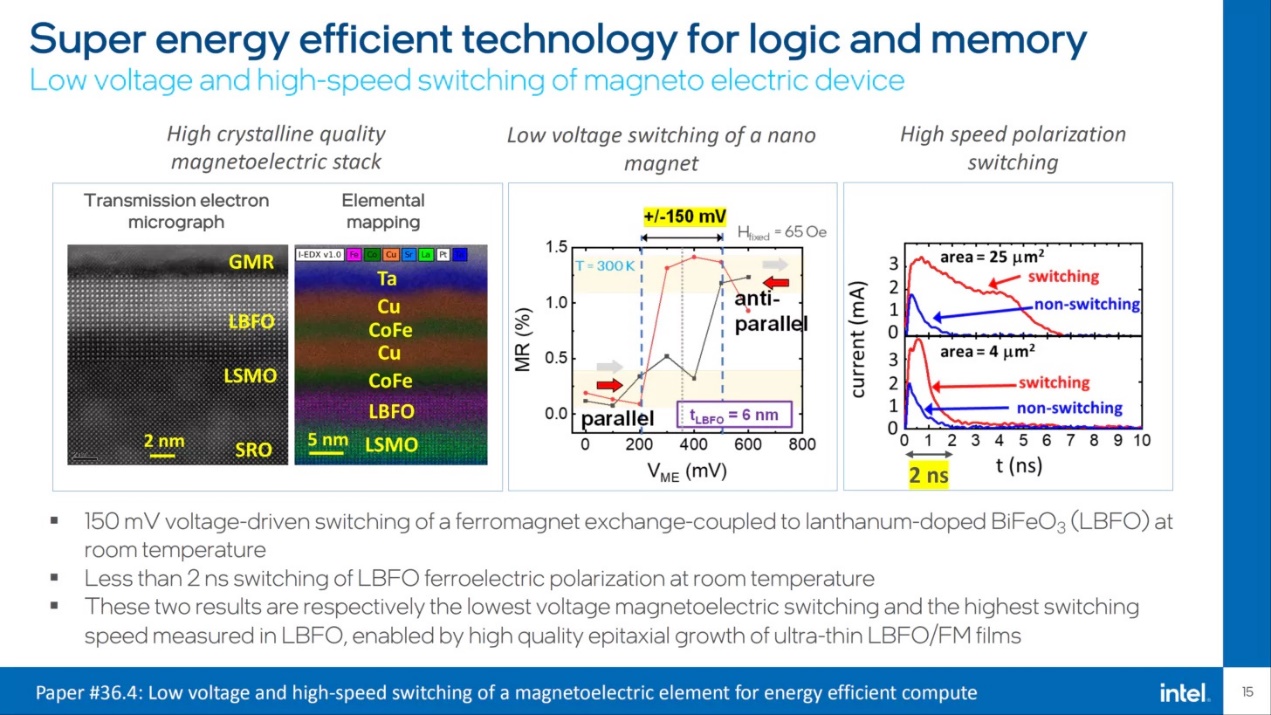
文章轉載自:ioioTimes
歡迎加入我們的 Facebook 粉絲團,隨時掌握最新消息!
喜歡看圖說故事的話,也可以追蹤 Instagram 專頁!
我們也有 Google News 可以隨時 follow!



